Intel nám toho včera naservíroval mnoho, takže pokračujeme v krasojízdě a tentokrát půjde především o inovace v pouzdření čipů. To je nedílným předpokladem pro zajištění dalšího výrazného pokroku a nám tu půjde o technologie Foveros.
Nové způsoby pouzdření čipů, které zásadně ovlivní podobu i výkon výsledných produktů, samozřejmě nemohly v prezentaci Intelu chybět. Už dlouho víme, že firmy jako AMD, NVIDIA či právě i Intel počítají s tvorbou vícečipových celků, což už se samozřejmě děje, ale dosud šlo spíše jen o připojení pamětí typu HBM nebo o spojení více čipů v rámci substrátu. Pokud mluvíme o novém využití interposerů, EMIB a podobných spojů, pak máme na mysli propojení více logických čipů, neboť právě až to může zajistit potřebný růst výkonu.
V podstatě tu ale není nic nového. EMIB dobře známe jako malé křemíkové spoje umístěné do substrátu pod okraji propojovaných čipů, zatímco Foveros jsou v podstatě interposery, velké křemíkové spoje sloužící jako další vrstva, která se tak rozprostírá pod celými propojenými čipy. EMIB se už dávno využívají a nově se uplatní i v chystaných serverových procesorech Sapphire Rapids, ovšem v jejich případě budou vylepšeny.
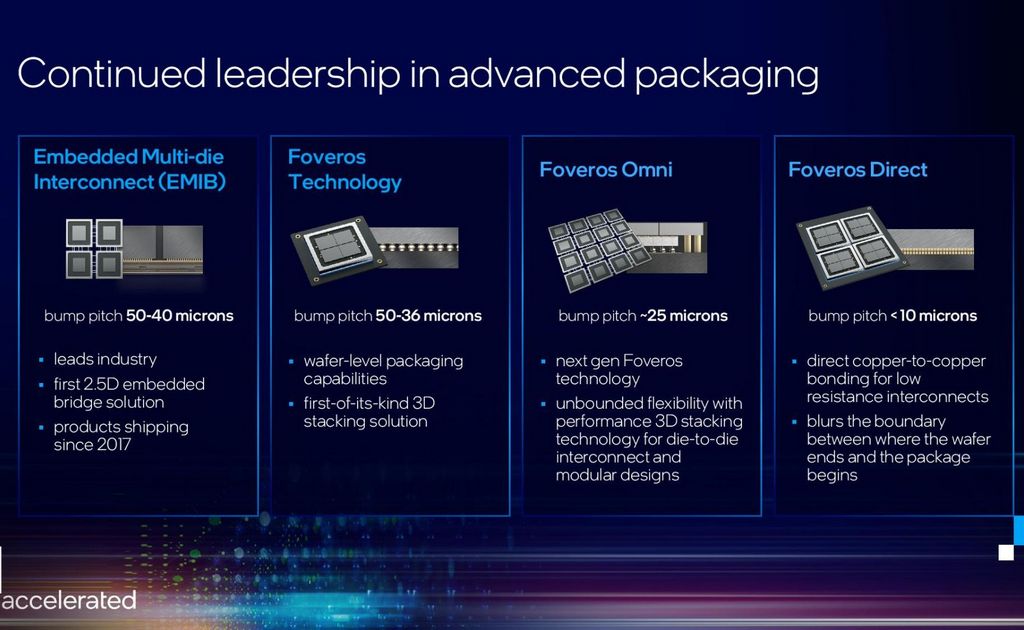
Jedním z hlavních měřítek je tu dle Intelu hustota datových spojů, což je vyjádřeno jejich vzájemným odstupem v mikrometrech. Původně měly EMIB odstup 55 μm, zatímco v případě Sapphire Rapids už to bude 45μm a to se má s vývojem technologie Foveros dále zlepšovat.

Foveros se už také uplatnila, a sice nejdříve v procesorech Lakefield. Nově bude využita v generaci Meteor Lake, kde už půjde o odstup 36 μm, což stále odpovídá původní verzi Foveros. Ale co bude dál?

- klikněte pro zvětšení -
Foveros Omni zvýší hustotu spojů (25 μm) s využitím jednak klasických TSV, vertikálních spojů skrz křemík, které poslouží pro data, přičemž měděné sloupky na okrajích zajistí napájení. Nově se tu tak oddělují napájecí a datové spoje, což zajistí celkově kvalitnější propojení v obou hlediscích. Jde v podstatě o technologii, která byla dříve oznámena jako Intel ODI.
Pak už nastoupí Foveros Direct (pouze 10 μm) s přímým propojením měděných kontaktů na povrch čipů, mezi nimiž tak už nebude žádná mezera. I díky tomu bude moci prudce narůst hustota spojů, sníží se jejich odpor, a tím i celková spotřeba, což poslouží k dalšímu zvýšení datové propustnosti. Intel si už Foveros Direct vyzkoušel na vrstvených paměťových čipech SRAM, ale kdy tuto technologii vyšle na trh, to se teprve ukáže.




















